集成電路產業沿著摩爾定律走到今天,持續推進的硅工藝節點難以為繼,伴隨著5G通信、汽車電子,人工智能、高性能計算等新興領域對集成電路產品與技術需求的增長,集成電路產業發展面臨諸多挑戰,例如如何實現更低的集成復雜度和更低的成本。
挑戰中也孕育著機遇,業界從單純的推進更先進的節點,轉向先進封裝驅動的芯片成品制造,以取得成本和性能的不斷優化。芯片成品制造正深刻地改變集成電路產業鏈形態,驅動包括芯片設計、晶圓制造、裝備、材料等產業鏈上下游更緊密的協同發展。
在這一趨勢下,長電科技提前布局設計服務等產品開發能力,依托技術領導力和行業領導力,不斷加強與上下游產業鏈伙伴的合作,發展新的商業模式,培育新的業務形態。長電科技設計服務事業中心專家認為,在這一過程中需通過“四個協同”,探索芯片-封裝-系統協同設計,實現更好的系統性能與可靠性,進而推動產業在后摩爾時代不斷進步。

圖:芯片-封裝-系統協同設計
產業鏈協同
芯片從一粒沙子變成一顆芯片成品進入到系統領域,涉及產業鏈的諸多環節,包括系統OEM/ODM、芯片Foundry、設計Fabless、封測OSAT、產品測試ATE等。以往芯片生產流程從制造、封裝到系統,各個環節之間形成了一種默認的邊界。封裝作為核心中間環節(芯片-封裝-系統),正在推動集成電路產業鏈的材料、設備、制造、工藝研發、硬件接口標準組織很好的配合起來,更好地連接半導體整個產業鏈、應用產業鏈和系統產業鏈。
長電科技認為,以前應用環節對半導體封測環節的關注和合作相對較少,但隨著封測在芯片制造中的作用越來越重要,不管是從供應鏈角度,還是從產品質量角度,應用環節的系統公司和封測產業鏈的協同變得越來越緊密。僅以汽車產業為例,越來越多的整車廠與封測產業積極配合,探索跨越產品生命周期的協同設計,雙方不僅僅是上下游和供應商的關系,而是更緊密的伙伴的關系。
多尺度協同設計(Multi-Scale Co-Design)
一個電子產品會經歷系統設計、芯片設計、芯片加工、封裝測試,到產品集成,在每個分工明確的領域之間會因為思維模式、專業背景、解決問題的方式不同,存在著不同的理解,而優秀的設計往往源于跨界的溝通、相互的理解與深度的合作。
特別是在當今的異構集成時代,協同設計與集成開發被寄以重望,成為先進SiP/Chiplet設計的主流趨勢。芯片上的晶體管尺寸是納米級,封裝互連是微米級,PCB是毫米厘米級,封裝的結構愈發復雜,傳統的IC-封裝-PCB依次的設計順序已經不能夠滿足現代電子產品的需求,系統級設計協同,融合設計,IC-封裝-PCB之間的綜合協同優化已成為必然。
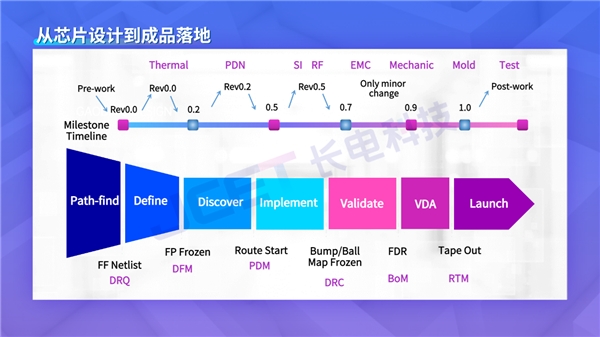
圖:從芯片設計到成品落地
多物理場協同設計(Multi-Physics Co-Design)
隨著異構集成功能模塊日益復雜,一個封裝系統可能要同時面臨光、電、熱、應力等多物理場耦合挑戰,業內需要越來越多的多物理場協同設計和仿真來應對這些挑戰。
在單顆芯片和封裝系統日趨復雜趨勢下,為了確保半導體封裝滿足性能要求,長電科技在芯片的開發過程中,通過與前后端客戶緊密合作仿真,推動協同設計。封裝的“聯合設計”營造了良好的開發環境,為實現更優異性能提供助力,也可在微系統集成服務商業模式上提供更多可能。
設計與制程工藝協同創新
后摩爾時代,集成電路已經不再單純地只以線寬線距和集成度的尺寸論英雄,而是更多地考慮如何提升系統的性能、成本、可靠性、可復用性等等。隨著集成電路系統復雜性的增加,尤其是高級封裝中的多尺度交互(芯片-封裝-系統),傳統的基于設計規則的DFM(單向)已不是優選設計方案。
長電科技認為,需要設計與制程協同優化的聚合式管理,“制程窗口”的確認和設計流程優化,讓系統實現更高的效率與更低的能耗,即Higher efficiency and Lower Power。設計與制程技術的整合式優化和架構創新,推動設計和制造一體化,對于實現更優的PPA(功率、性能、面積)、可靠性、制造良率和總成本非常重要。
協同設計及優化對于打造有市場競爭力的集成電路產品變得越來越重要。因此,今天長電科技在設計階段就會與客戶、合作伙伴充分溝通,這樣在客戶做初始設計時,長電科技就可把相應的后道制造準備好。未來,長電科技將更加積極和業界合作推動芯片-封裝-系統協同設計的發展,推動行業更好的發展。
更多信息可以來這里獲取==>>電子技術應用-AET<<


