隨著芯片制造工藝的不斷進步,單個芯片的晶體管數(shù)量持續(xù)增長,從數(shù)萬級到今天的數(shù)百億級。
長期以來,提高晶體管密度一直是實現(xiàn)更大規(guī)模集成電路的主要途徑,我們的關(guān)注點也一直聚焦在芯片制程的升級上。
但隨著工藝臨近物理極限,這種路徑已經(jīng)難以為繼,多芯片封裝技術(shù)的出現(xiàn)了,給了我們另一種提升晶體管數(shù)量和電路規(guī)模的途徑。

就像臺積電最近在IEDM展示的芯片技術(shù)線路圖那樣,在這張線路圖上有3D Hetero Integration和Monolithic Integration兩種不同的芯片集成方式:
1、3D Hetero Integration,即異質(zhì)3D集成技術(shù)。它是通過垂直堆疊和互連多個不同功能的裸芯片(Chiplet),實現(xiàn)芯片堆疊的一種封裝與互連技術(shù)。其優(yōu)點是可以混合匹配不同工藝節(jié)點的芯片,實現(xiàn)更高性能密度。
2、Monolithic Integration,即單體芯片一體化技術(shù)。它是在一塊硅基板上,使用統(tǒng)一的制造工藝集成不同功能的電路元件,產(chǎn)出單個大規(guī)模的復(fù)雜芯片。其優(yōu)點是信號傳輸更快,芯片之間沒有互連瓶頸。
兩者都是實現(xiàn)大規(guī)模集成電路的重要方式。3D Hetero Integration依賴封裝技術(shù),Monolithic Integratio則依賴制程技術(shù),在兩者共同作用下,臺積電預(yù)計在2030年前后實現(xiàn)整合超過1萬億個晶體管的芯片解決方案,單體芯片的晶體管數(shù)量也在快速增長到2000億級,工藝制程將來到1納米。
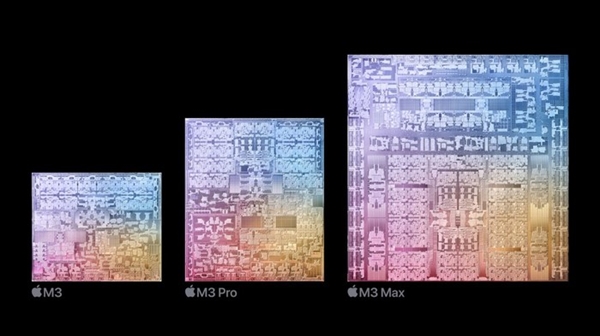
目前最大規(guī)模的單體芯片是蘋果的M3 Max,這顆芯片中的晶體管數(shù)量達到920億個,采用最先進的臺積電3nm工藝制造。而在上一個工藝節(jié)點上(臺積電4nm),最大的單體芯片是NVIDIA的H100 GPU,其核心集成有800億個晶體管,芯片面積為814平方毫米。
至于多芯片集成方案,多見于AMD和英特爾的數(shù)據(jù)中心加速卡上,比如AMD今年推出的Instinct MI300X AI加速卡,借助臺積電SoIC 3D片間堆疊和CoWoS先進封裝技術(shù),其內(nèi)部集成了12個5/6nm工藝的小芯片(HMB和I/O為6nm),晶體管數(shù)量達到驚人的1530億個。
而英特爾的Ponte Vecchio集成了47個FPGA和HPC加速器芯片,整套芯片包含了驚人的1000億個晶體管。
在面向普通用戶的產(chǎn)品中,AMD比Intel更早采用了多芯片封裝技術(shù)。早在2017年發(fā)布的EPYC服務(wù)器處理器中,AMD就使用了多芯片模組(MCM)方案,在同一個處理器封裝內(nèi)集成了多個芯片級別的組件。
在2019年,該技術(shù)應(yīng)用于Ryzen系列消費級處理器中,采用Zen2架構(gòu)的AMD Ryzen 3000系列,首次使用晶片分離設(shè)計,其核心部分使用成本較高的臺積電7nm,IO部分使用12nm,最后將核心和IO兩個部分集成在同一塊基板上。
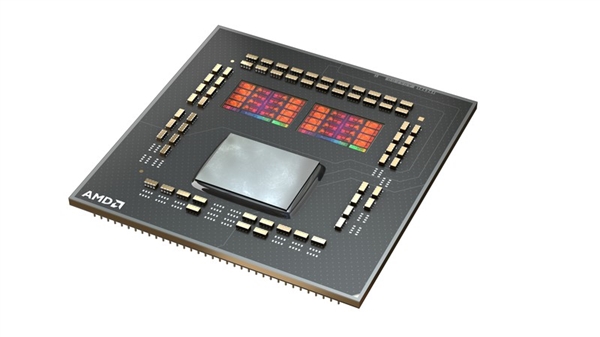
隨后,AMD持續(xù)優(yōu)化了Chiplet架構(gòu),使AMD在性能和性價比上都占據(jù)明顯優(yōu)勢,獲得了巨大商業(yè)成功。
相比之下,Intel直到2024年底發(fā)布的酷睿Ultra處理器中,才在消費級產(chǎn)品上使用了多芯片集成封裝技術(shù),雖然比AMD的Ryzen系列稍晚,但這標(biāo)志著x86芯片制造商全面進入多芯片時代。
酷睿Ultra具有Compute Tile、Graphics Tile、SoC Tile和I/O Tile四個小芯片,通過英特爾Foveros 3D封裝技術(shù)連接到一起,在核心架構(gòu)上實現(xiàn)了異構(gòu)整合。
據(jù)Intel介紹,F(xiàn)overos 3D封裝技術(shù)的核心是通過微觸點(Microbump)在邏輯芯片基板上垂直堆疊多個裸露芯片,并用TSV(通孔)實現(xiàn)芯片間的信號垂直互聯(lián)。這種垂直3D封裝方式可以實現(xiàn)異構(gòu)芯片的混合封裝和匹配,其空間效率和性能密度都很高,大大提升了芯片設(shè)計的靈活性。
毫無疑問,多芯片集成封裝技術(shù)已經(jīng)成為現(xiàn)在乃至未來五年芯片發(fā)展的重要技術(shù),同時也讓我們對過去封裝技術(shù)的演進產(chǎn)生了興趣。
芯片封裝的發(fā)展歷史和代表產(chǎn)品:
1、DIP封裝:雙列直插封裝,1970-1980年代流行,典型產(chǎn)品為8086 CPU。
2、PGA封裝:帶連接孔的封裝形式,因Intel 80486而流行。
3、PQFP封裝:塑料四方扁平封裝,應(yīng)用于1990-2000年代的微處理器。
4、BGA封裝:球柵陣列,以Pentium作為典型產(chǎn)品,90年代中后期流行。
5、Flip Chip CSP: 翻轉(zhuǎn)芯片芯片級封裝,應(yīng)用于Intel Core和AMD Athlon系列CPU。
6、MCM封裝:多芯片模塊封裝,EPYC服務(wù)器處理器。
7、Chiplet封裝:面向現(xiàn)代處理器和AI加速器,如Zen 4和Intel Ponte Vecchio采用。
隨著芯片的小型化和功能的增加,封裝技術(shù)也在不斷發(fā)展,以滿足電性能和成本的需求。
這些多樣的封裝互連技術(shù)也必將不斷演進與創(chuàng)新,推動產(chǎn)業(yè)實現(xiàn)更高性能與復(fù)雜度的異質(zhì)融合芯片,以滿足AI、高性能計算等應(yīng)用的持續(xù)需求。制程與封裝的協(xié)同發(fā)展,也將開啟電子信息產(chǎn)業(yè)新的成長空間。


